クリアライズでは、断面SEM観察後、FIBマイクロサンプリングと薄膜加工で、特定微小部のTEM及びSTEM観察が可能ですが、FIB加工でダメージが入りやすいGaNは、冷却状態でのFIB加工やArイオンビームによる加工を併用することにより、ダメージが軽減された薄膜を作製することができます。
ホームページ上では、GaN層表層部をSTEM観察及びEDXマッピング分析した結果やAlGaNの高分解能STEM分析結果等もご紹介しております。
さらに、技術資料をダウンロードいただきますと、GaN層の二次電子像と明視野STEM像を取得した結果などもご覧いただけます。明視野STEM像ではGaN層内部の転位を評価することが可能になります。
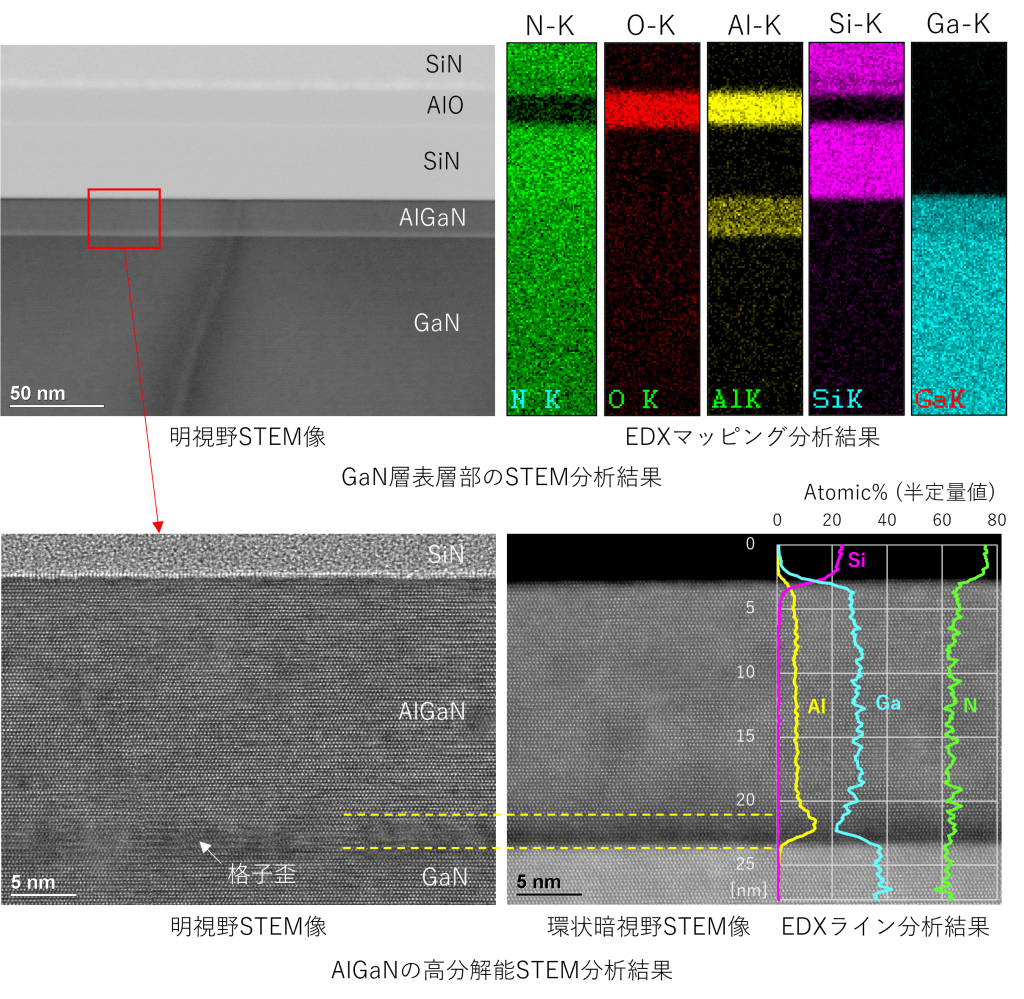

GaN (gallium nitride):窒化ガリウム
SEM (Scanning Electron Microscope):走査電子顕微鏡
TEM (Transmission Electron Microscope):透過電子顕微鏡
STEM (Scanning Transmission Electron Microscope):走査透過電子顕微鏡
FIB (Focused Ion Beam):集束イオンビーム
EDX (Energy Dispersive X-ray spectroscopy):エネルギー分散型X線分光法


