半導体
パワー半導体観察分析
半導体の主戦場は、自動車だ。
パワー半導体の分析・試験
自動車のEV化が進む中、半導体は自動車の主要部品となっており、その使用条件も過酷な方向に進んでいます。
クリアライズは、皆様の使用条件に対応した試験や試験前後の半導体等電子部品の分析・調査で皆様をサポートいたします。
電子部品の非破壊構成要素観察
①製品状態の構造観察

②調査サンプルの解体/分析対象採取
-
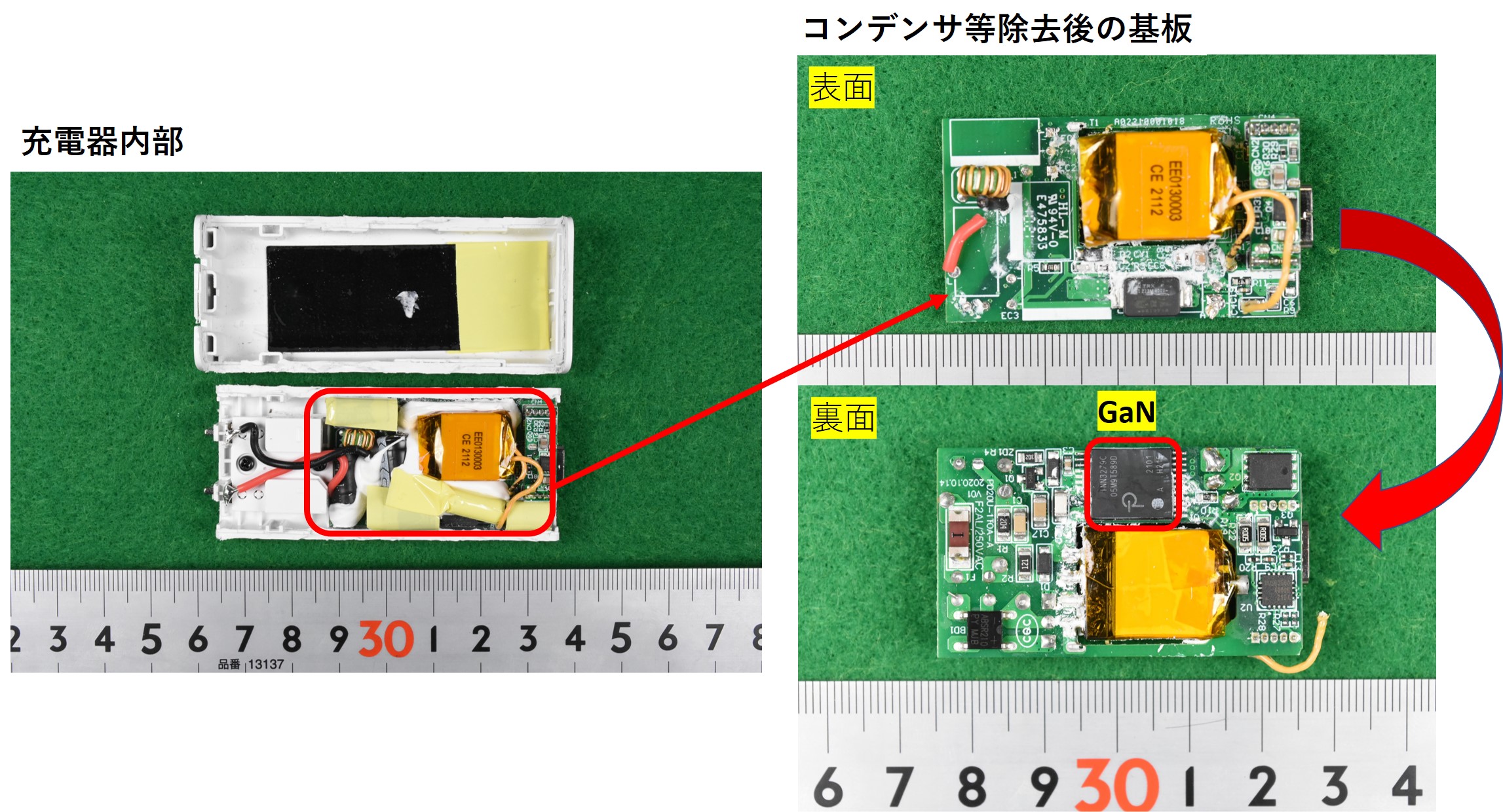
-
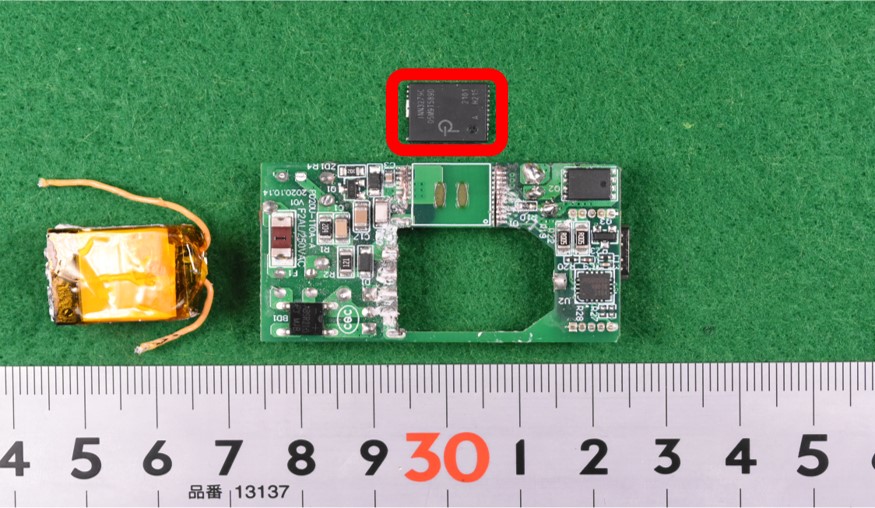
分析対象(GaN)の試料採取
③分析対象単体の構造観察
-

GaN -
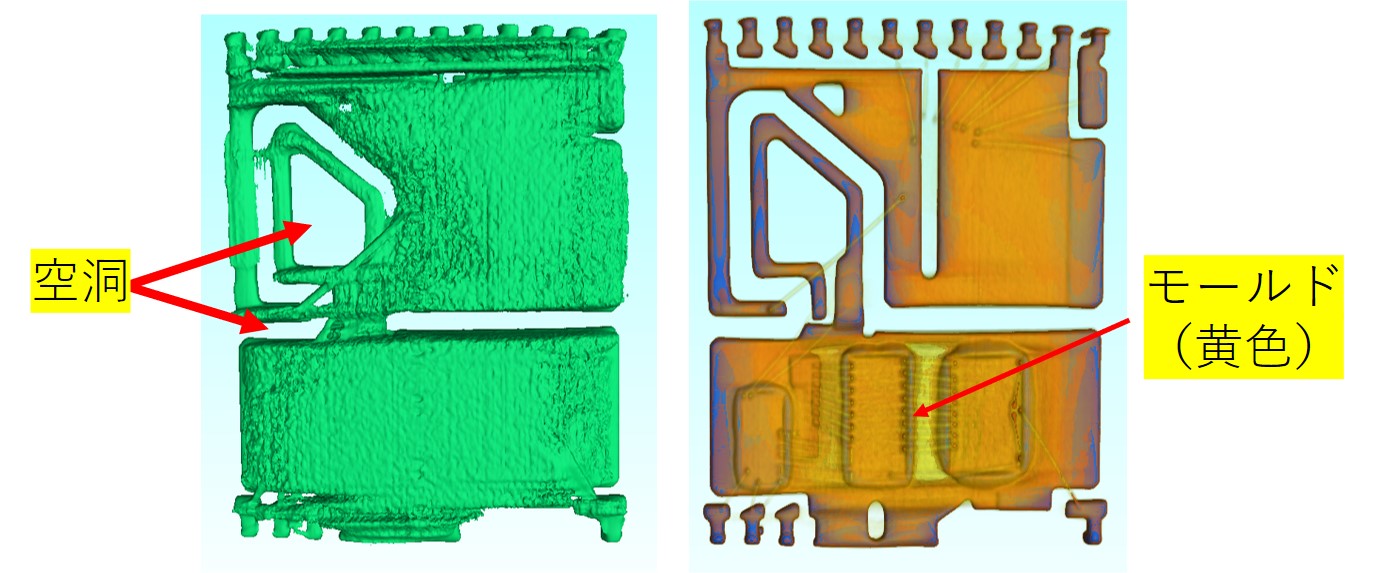
X線CT -
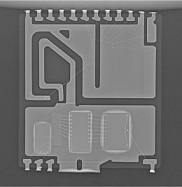
X線CT
【参考動画】X線観察調査事例
-
X線観察調査事例
観察用薄膜試料加工技術(FIB加工)
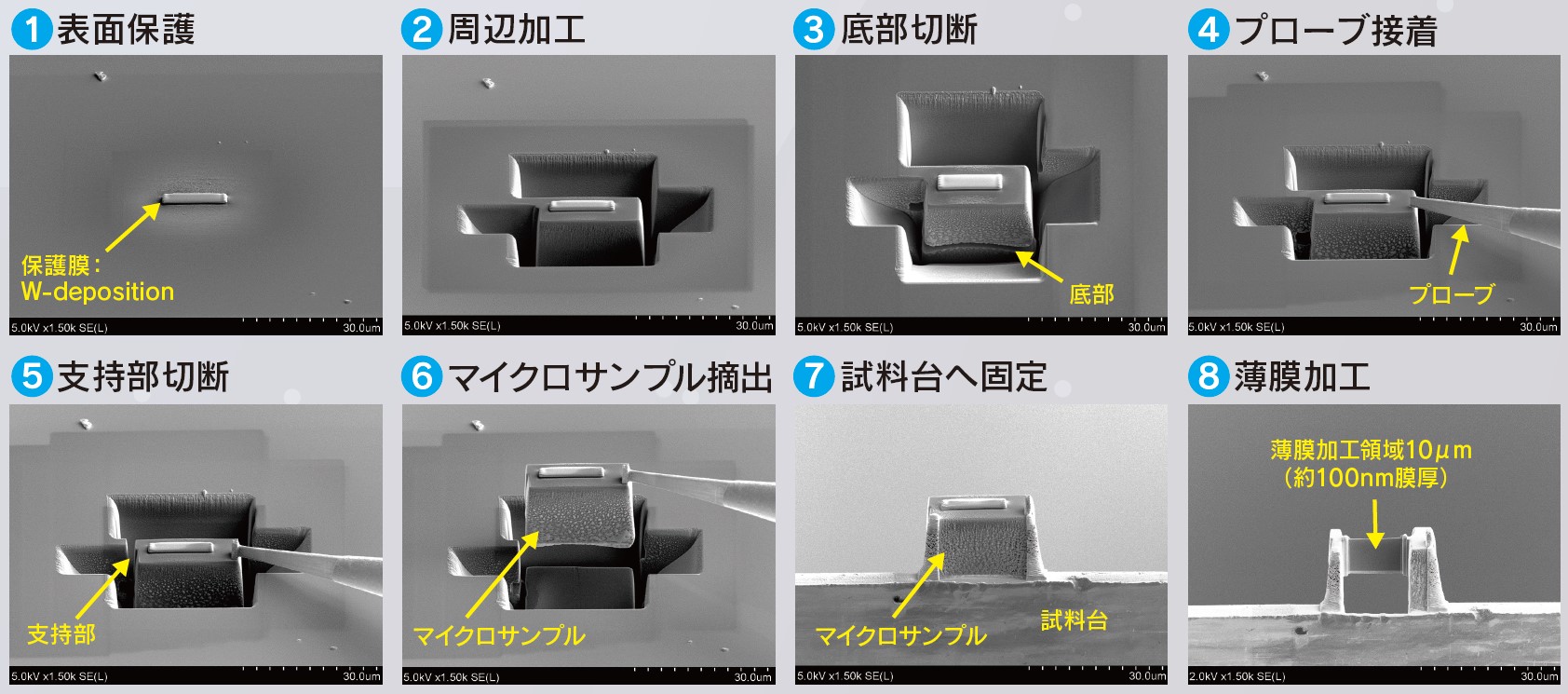

FIB加工でダメージの入りやすい試料は、冷却(クライオ)加工し試料ダメージが軽減された薄膜を作成します。
試料に応じてCP加工と組み合わせた断面出し、大気非曝露加工を実施し、目的の観察・分析内容にて応じて最適な前処理を含む試料調整を実施します。(年間FIB加工数:約400件)
試料に応じてCP加工と組み合わせた断面出し、大気非曝露加工を実施し、目的の観察・分析内容にて応じて最適な前処理を含む試料調整を実施します。(年間FIB加工数:約400件)
【参考動画】FIB法による試料加工等のご紹介
-
STEM分析サービス
GaNパワーデバイスの分析事例
-
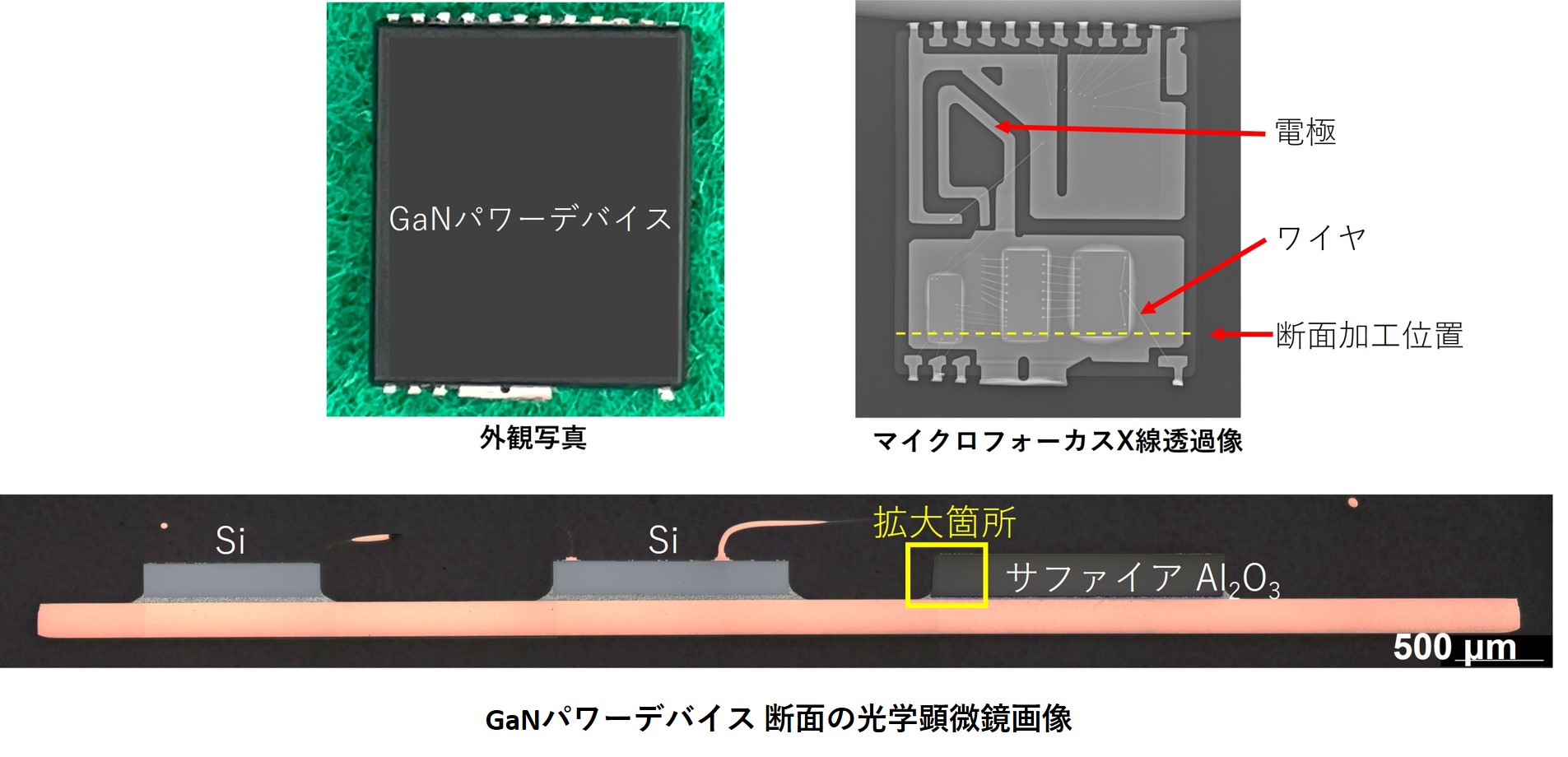
①GaNパワーデバイスの内部構造と断面構造
-
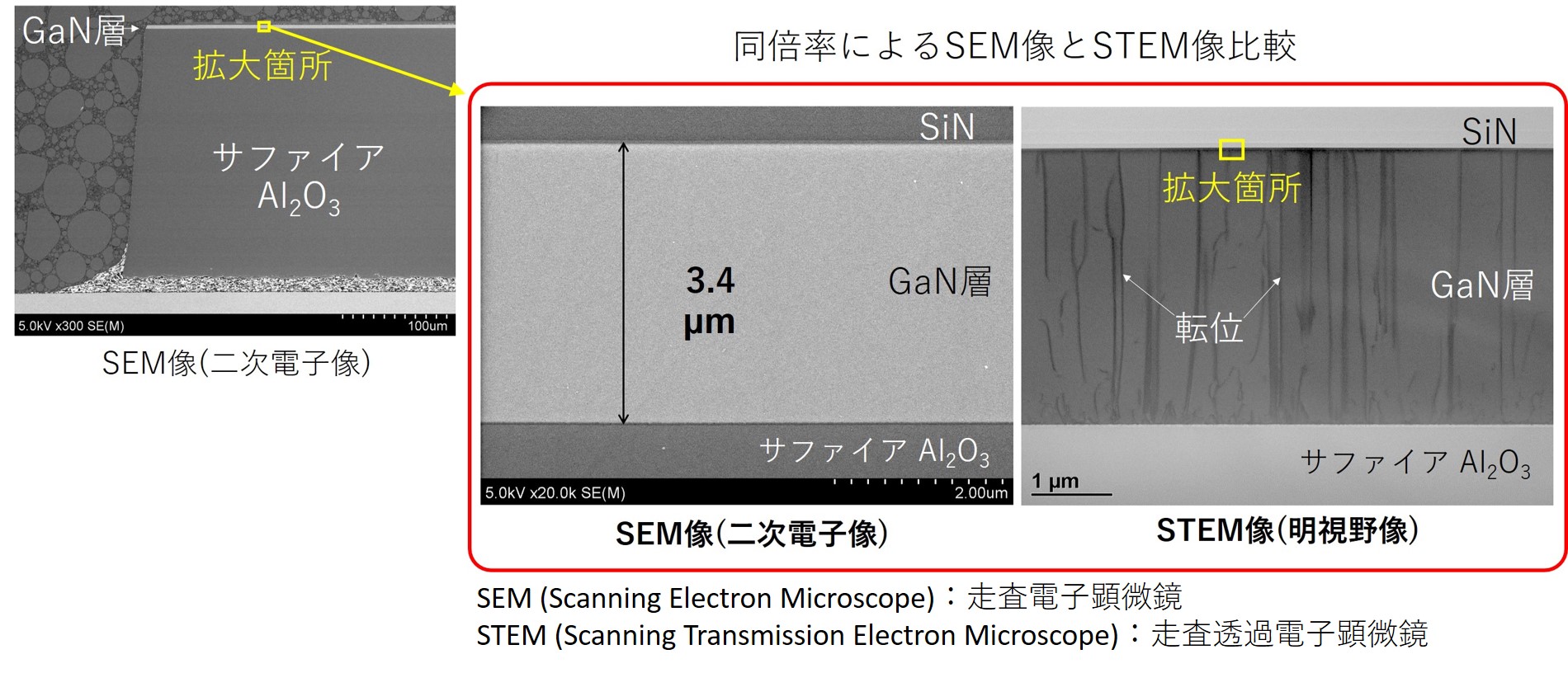
②GaN層のSEM像とSTEM像
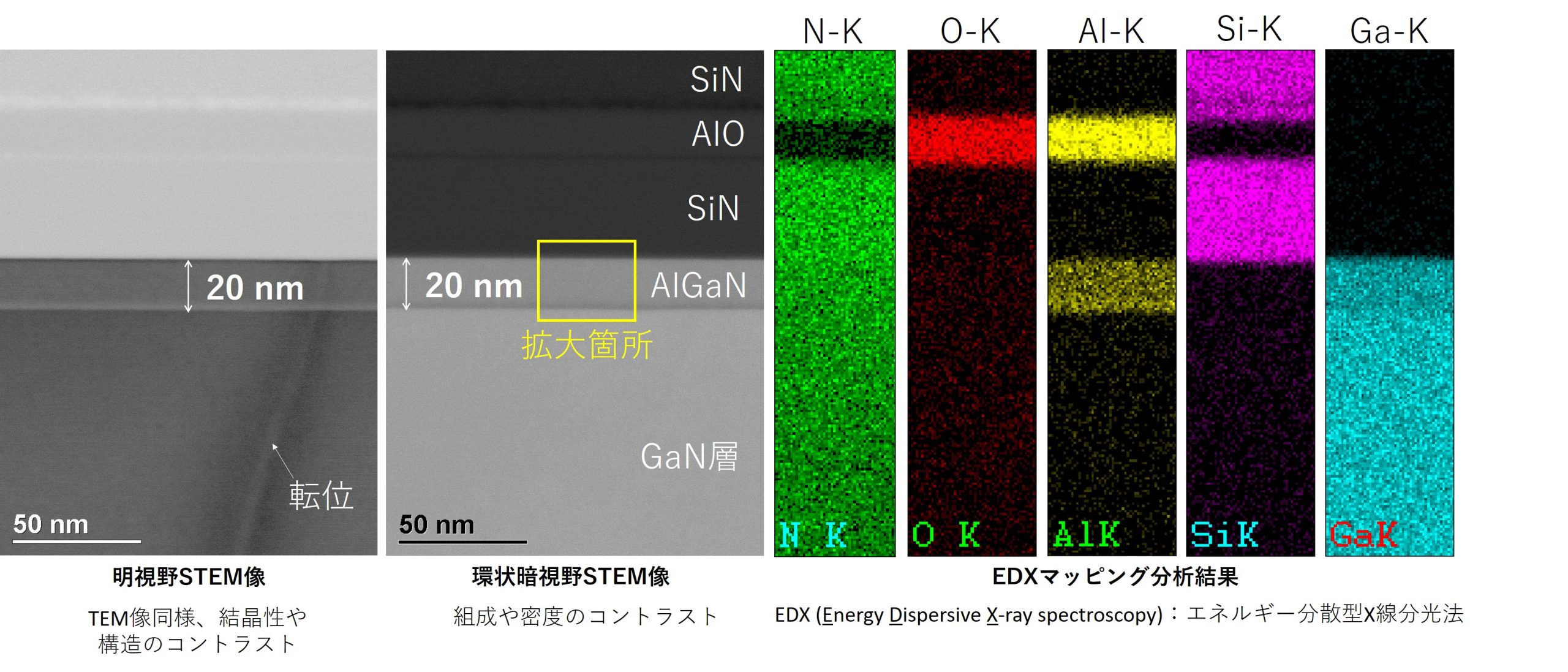
③GaN層表層部のSTEM-EDXマッピング分析
-
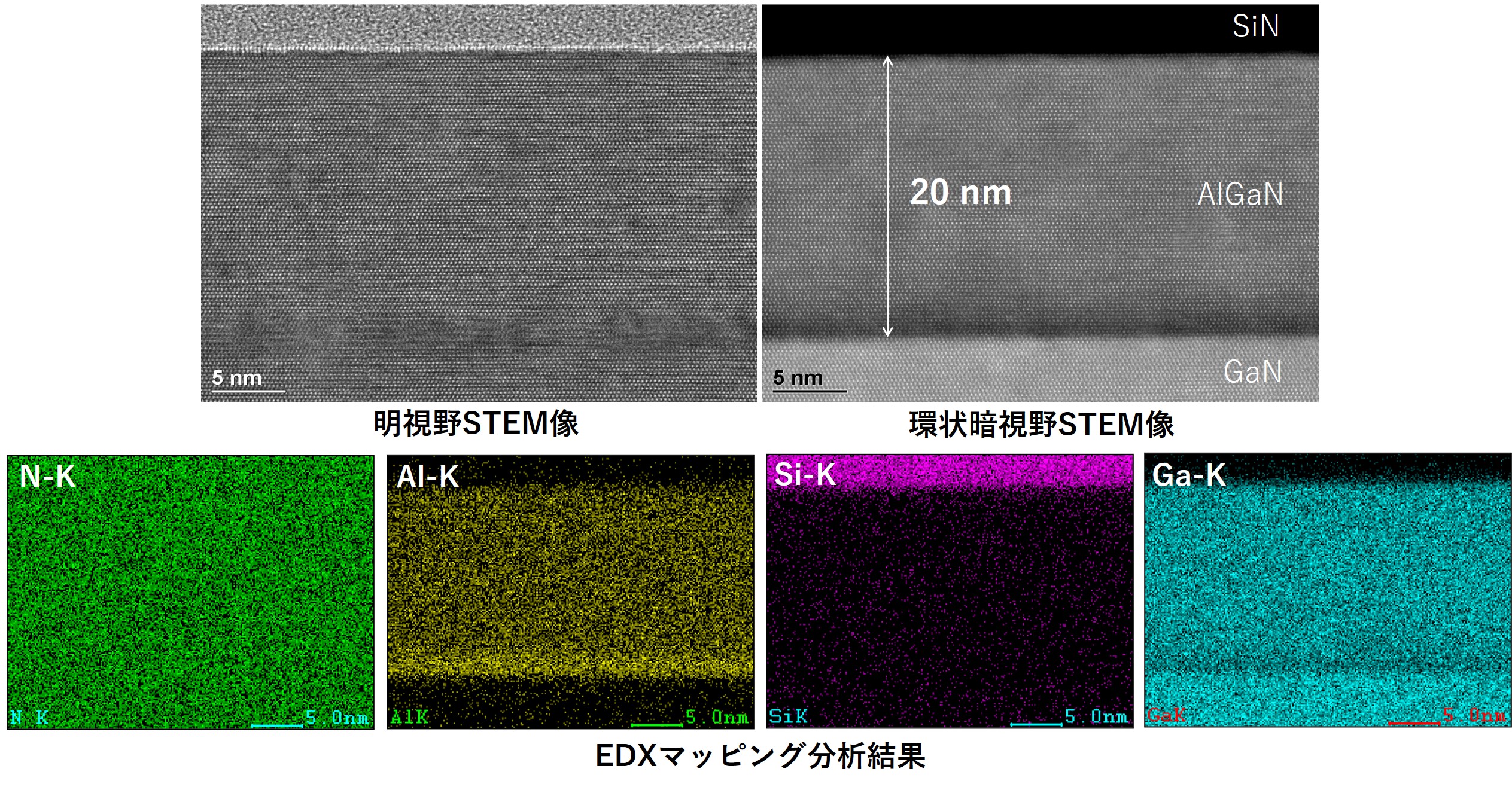
④AIGaNの高分解能STEM観察と
EDXマッピング分析 -
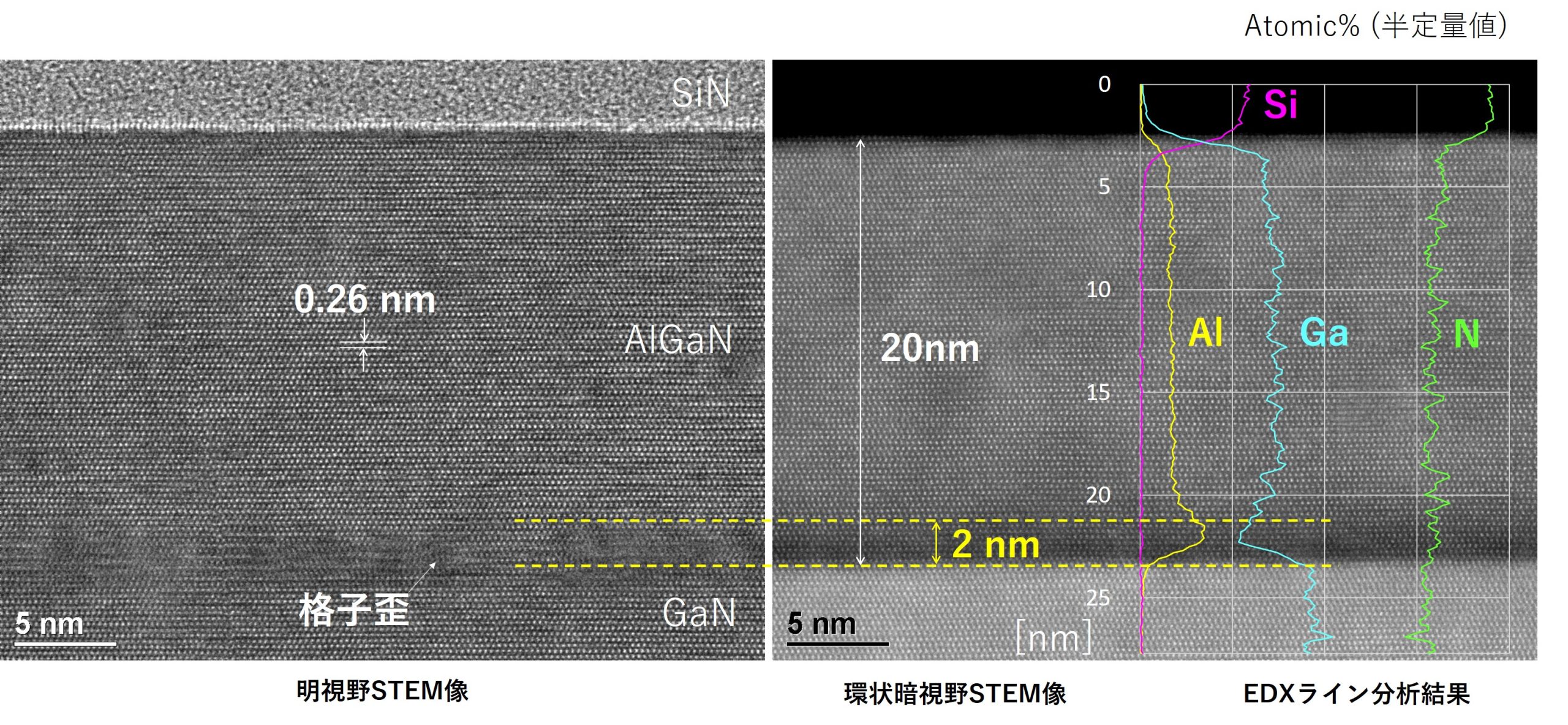
⑤AIGaNの高分解能STEM観察と
EDXライン分析
【参考動画】高性能なパワー半導体を実現するGaNを特定微小部多方向から観察
-
GaNパワーデバイスSTEM分析事例
SiCチップの健全性調査
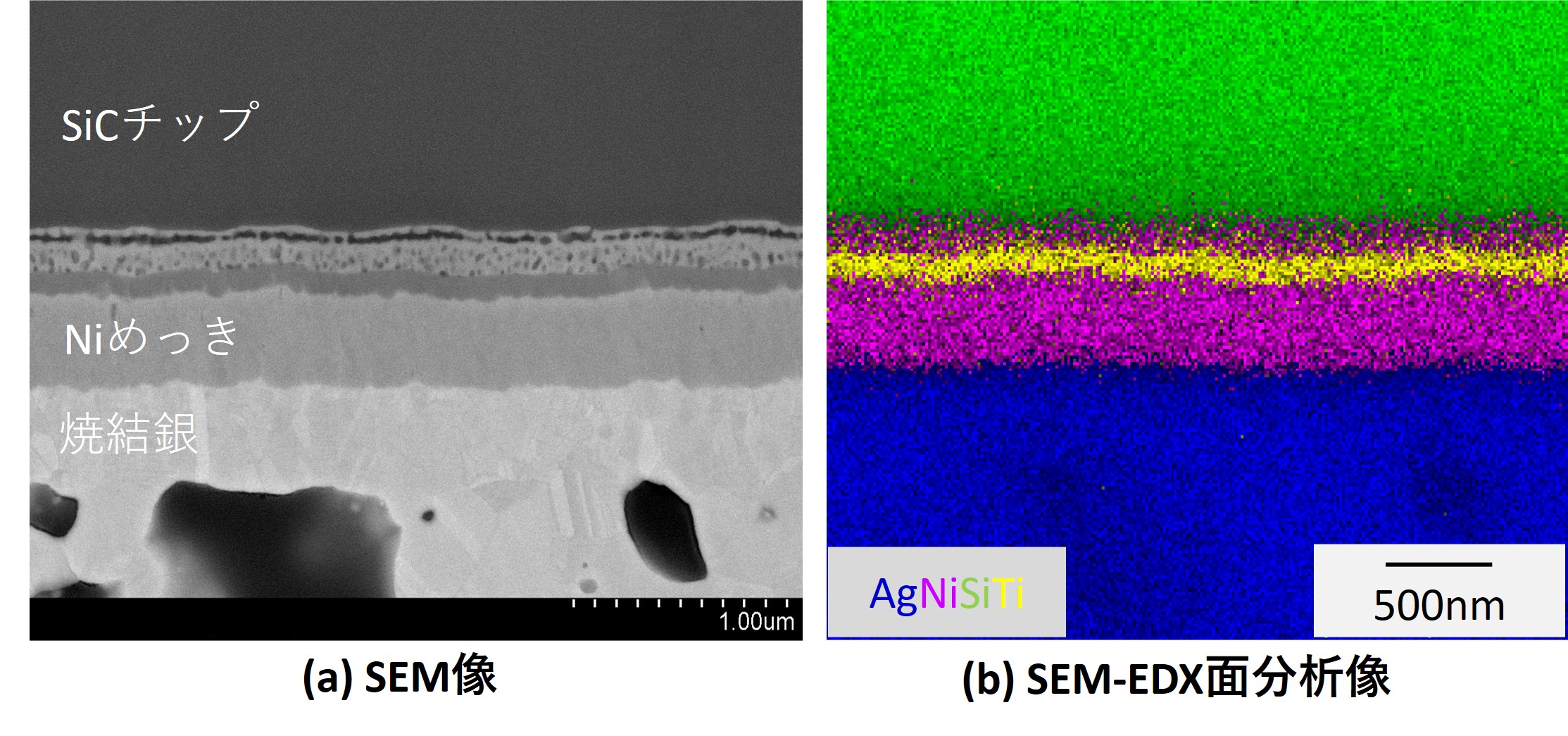
SiCは硬くSiと比べて加工性が悪く、断面観察試料作製が難しいとされています。
イオンミリング法を用いることでチップ端面まで鮮明な像が得られ、チップの損傷・解析に有効です。
機械研磨法では難しい2000HV以上のSiCチップと15HVのはんだ接合界面もダレのない平滑な断面作製が得られます。
イオンミリング法を用いることでチップ端面まで鮮明な像が得られ、チップの損傷・解析に有効です。
機械研磨法では難しい2000HV以上のSiCチップと15HVのはんだ接合界面もダレのない平滑な断面作製が得られます。


