微細構造観察
走査透過電子顕微鏡(STEM)分析
走査透過電子顕微鏡(STEM)分析 概要
最先端材料開発に必須!原子レベルの構造・組成分析なら、クリアライズのSTEM分析。球面収差補正装置搭載で高分解能観察、元素マッピング、化学結合状態解析まで対応。受託分析サービスで、貴社の研究開発を加速します。
・球面収差補正 走査透過電子顕微鏡(STEM)
・透過電子顕微鏡 (TEM)
・集束イオン/電子ビーム加工観察装置(FIB-SEM)
【STEMによるGaN(窒化ガリウム)分析事例】
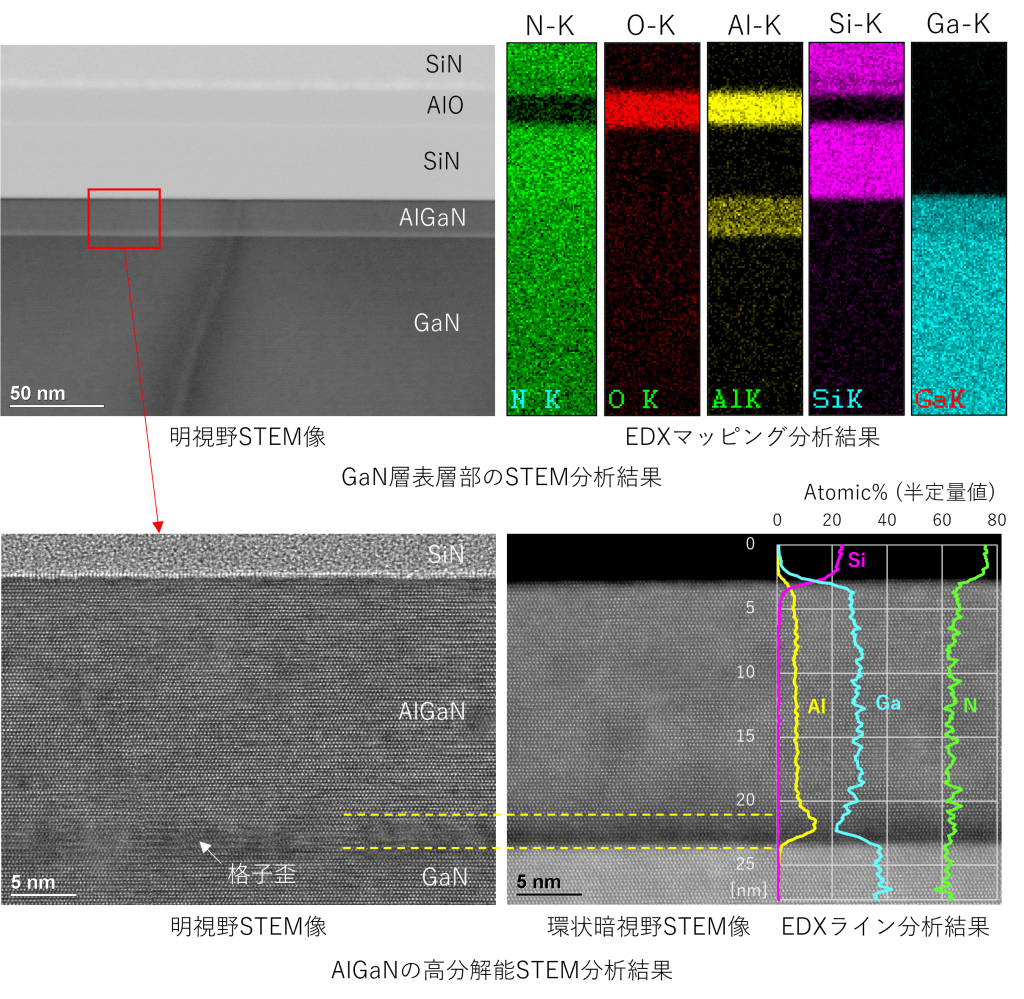
上事例に示した高分解能STEM分析では、AlGaN/GaN界面においてAlの濃化が確認されていますが、この濃化部においては、格子歪の影響で明瞭な格子像が観察されていません。通常のFIB加工ではダメージと区別が付かない試料の格子歪も、冷却FIB加工やArイオンミリング加工により、試料本来の結晶構造を把握することが可能です。
詳しくご覧になりたい方は、「技術資料ダウンロード」ページより
(物性評価)「GaNパワーデバイスのSTEM分析」をダウンロードください。
走査透過電子顕微鏡(STEM)分析 特長

高分解能観察
球面収差補正器搭載によって原子レベルの高分解能で、明視野STEM像、環状暗視野STEM像、二次電子像が取得可能です。
高感度EDX*1分析
大口径100mm2SDD*2によって、微小領域、微量元素の高感度EDX分析が可能です。
高エネルギー分解能EELS*3分析
冷陰極電解放出形電子銃とDualEELSの組み合わせによって、高エネルギー分解能で高精度なEELS分析に対応、組成分析や化学結合状態の評価が可能です。
有償公開分析サービス
事前に準備した薄膜試料、もしくは当日お持ちいただいた試料を用いて、半日・一日単位の立会い分析が可能です。熟練したオペレーターの操作で、試料状況を確認しながら、観察・分析箇所や各種条件の指定ができます。 なお、当日測定したデータは、即日お持ち帰りいただけます。
*1EDX :Energy Dispersive X-ray Spectroscopy
エネルギー分散型X線分光法
*2SDD : Silicon Drift Detector
シリンコンドリフト検出器
*3EELS : Electron Energy-Loss Spectroscopy
電子エネルギー損失分光法
主な装置・仕様
走査透過電子顕微鏡(STEM)
機種
日立ハイテク社製 球面収差補正日立走査透過電子顕微鏡 HD-2700
仕様
- 電子銃:冷陰極電解放出形電子銃
- 加速電圧:200 kV , 120 kV , 80 kV
- 映像信号:
明視野STEM像 [BF(Bright Field)-STEM image]
環状暗視野STEM像 [ADF(Annular Dark Field)-STEM image]
二次電子像 [SE(Secondary Electron) image]
特定回折暗視野STEM像 [SD(Selected Diffraction)-STEM image]
電子回折像 (Diffraction pattern) - 分析装置:
EDX (AMETEK Octane T Ultra W 100mm2SDD)
EELS (AMETEK GATAN Enfinium)
特長
- 像分解能:0.136 nm
- 倍率:x100 〜 x10,000,000
「STEM分析」サービス紹介
-
(株)クリアライズ受託分析サービス紹介「STEM分析」
透過電子顕微鏡(TEM)
機種
日立ハイテク社製 透過電子顕微鏡 HF-2100
仕様
- Cold FE-TEM (STEMユニット付き)
- 加速電圧:200kV
- 分解能:0.24nm
- 倍率:200倍〜1,500,000倍
- EDX検出器搭載
STEMの主な仕様
- 倍率:100倍〜5,000,000倍
- 検出信号:二次電子像(SE) Zコントラント像(HAADF-STEM)
位相コントラスト像(BF-STEM)
集束イオン/電子ビーム加工観察装置(FIB-SEM)
機種
日立ハイテク社製 集束イオン/電子ビーム加工観察装置(FIB-SEM) NB5000
仕様
- FIB: Ga液体金属イオン源 加速電圧:10~40 kV
SIM像(Scanning Ion Microscope image)分解能:5 nm - SEM: ショットキーエミッション形電子銃 加速電圧:~30 kV
二次電子像分解能:2 nm - マイクロサンプリング機構装置
- 日立ハイテク社製SEM・TEMとの共有ホルダー
特長
- 像分解能:10nm以下
- 倍率:最大28万倍
- 加工位置精度:0.1μ m以下
- 膜厚0.1μm以下の薄膜加工可
適用分野
- デバイス不良箇所の断面加工と観察
- 複合材料、有機材料の断面加工
- 金属薄膜の結晶粒観察
試料
- 最大試料サイズ:直径30mmφ×厚さ15mm
分析方法の詳細
球面収差補正 走査透過電子顕微鏡(STEM)
1. 概要
走査透過電子顕微鏡(STEM:Scanning Transmission Electron Microscope)は、微細化が進む材料やデバイス製品を原子レベルでの評価が可能です。HD-2700形STEMには、レンズの球面収差を補正する球面収差補正器(Cs-corrector)が搭載されており、構造・組成・化学結合状態を高水準で評価することができます。

■高分解能観察:
球面収差補正器搭載によって高分解能(原子レベル)な明視野STEM像、環状暗視野STEM像、二次電子像の取得が可能
■高感度EDX分析:
大口径100mm2SDDにより、微小領域、微量元素の高感度分析が可能
■高エネルギー分解能EELS分析:
冷陰極電解放出形電子銃とDual EELSの組み合わせによって、高エネルギー分解能で高精度なEELS分析に対応、組成分析や化学結合状態の評価が可能
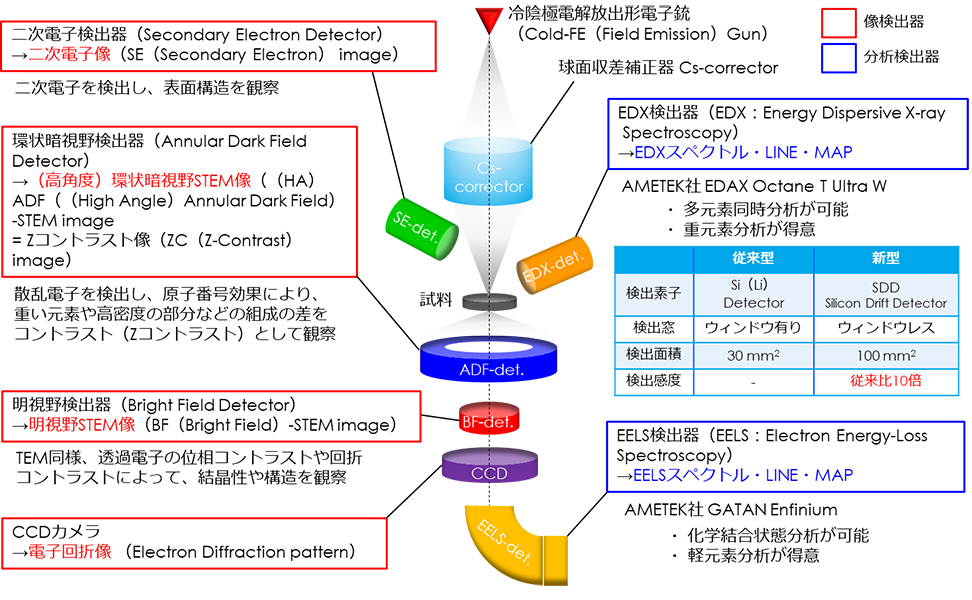
4.分析事例
①高分解能観察事例
半導体デバイスに多く用いられるSiの<110>方向の環状暗視野STEM像では、Si原子列の0.136 nm間隔で並ぶダンベル構造が観察できます。 Siの結晶構造モデルを図1に、Si<110>方向からの環状暗視野STEM像を図2に示します。サブナノメートルの電子線プローブによって、原子列の可視化が可能です。
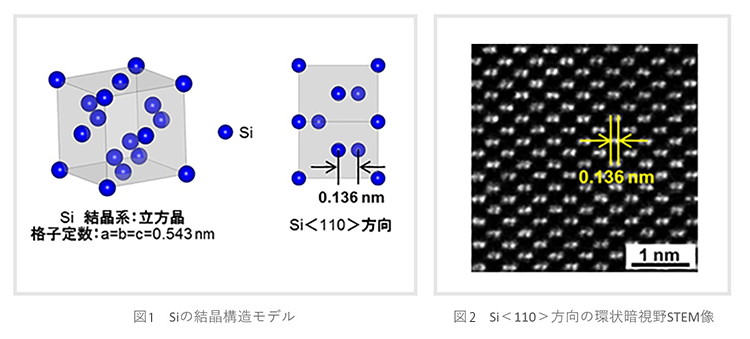
②貴金属触媒(Ptコア/Pdシェル構造)のSTEM観察

③高感度EDX分析事例
燃料電池などに用いられる貴金属触媒は、数nmの微粒子で形成されています。図3は、コアシェル構造を持つ触媒粒子のSTEM像、SEM像およびEDXマッピング分析をした結果です。PtコアPdシェルの元素分布が明瞭に観察されています。
また、図4に示すようなEDXライン分析によって、強度比を測定することも可能です。

④カーボン材料の高エネルギー分解能EELS分析
カーボンは結合状態の違いによって、EELSスペクトルの微細構造が異なります。高エネルギー分解能EELS分析によって、sp2結合のアモルファスやグラファイトだけπ*ピークが確認できます。STEM-EELS分析では、原子レベルの分解能で組成や化学結合状態の情報を得ることが可能です。

⑤高分解能・高感度EDX分析事例
球面収差補正器を使用することで、大きな収束角度で微小な電子線プローブが得られます。さらに、大口径SDDとの組み合わせで、原子レベルのEDX分析も可能です。 セラミック材料であるSrTiO3の結晶構造モデルを図5に、SrTiO3<110>方向のEDXマッピングの分析結果を図6に示します。環状暗視野STEM像で観察された原子列について、組成情報を把握できます。
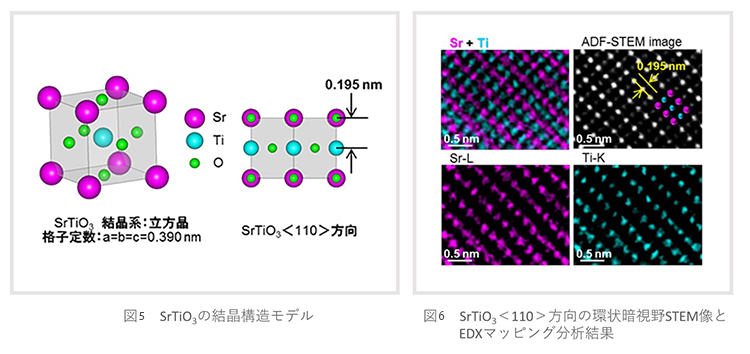
透過電子顕微鏡 (TEM)
1. 概要
透過電子顕微鏡(TEM: Transmission Electron Microscope)は、微小領域の観察及び解析が可能な装置です。
回折コントラストを生かした明視野像、特定の回折波で結像した暗視野像、更に格子像や電子回折の取得で材料解析に貢献することができます。

2. 特徴
Cold FE銃が搭載され、ナノプローブ電子回折が取得可能です。また、CCDカメラシステムでInsitu観察も可能です。
3.主な用途
金属材料、触媒、半導体デバイス、各種ナノ材料…等
ナノエリアの断面観察及び結晶格子構造観察
4. 分析事例
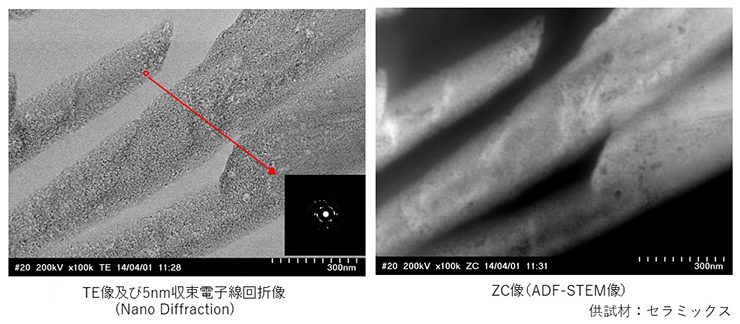
集束イオン/電子ビーム加工観察装置(FIB-SEM)
1.概要
集束イオンビーム(FIB:focused ion beam)装置はガリウム(Ga)イオンを試料上に照射しながら走査し、試料の観察(SIM:scanning ion microscope 像)や加工を行う装置です。
SEM機能を有しているため加工途中や加工後のSEM観察が可能で目的の領域を正確に加工して断面や薄片試料が得られます。
2.主な用途
■透過電子顕微鏡(TEM)や走査透過電子顕微鏡(STEM)観察用の薄膜試料作製
■走査電子顕微鏡(SEM)やSIM観察用の断面試料作製
■試料断面、表面の結晶粒の観察
■タングステン(W)膜を指定領域に成膜
■各種顕微鏡観察用試料の作製
3.装置仕様
■装置名 : 日立ハイテク社製 NB5000 (マイクロサンプリング付属)
■FIBイオン源 : Ga液体金属イオン源
■FIB加速電圧 : 10~40kV
■観察 : SIM像、SEM像
■試料サイズ : 30φ×15㎜
■Depositionガス源 : W(CO)6

① Cu板上のNiめっき断面のSIM観察
■加工直後の断面の様子を観察できます。
■SEM像とは異なり、Cu/Niのような原子番号が近い元素であってもコントラストに差異が現れます。
試料から薄膜試料作製位置周辺(数十µm×数µm角)をピックアップし、観察用メッシュに固定します。
これを100nm以下まで薄膜化することで、TEM/STEM用観察試料に供することができます。
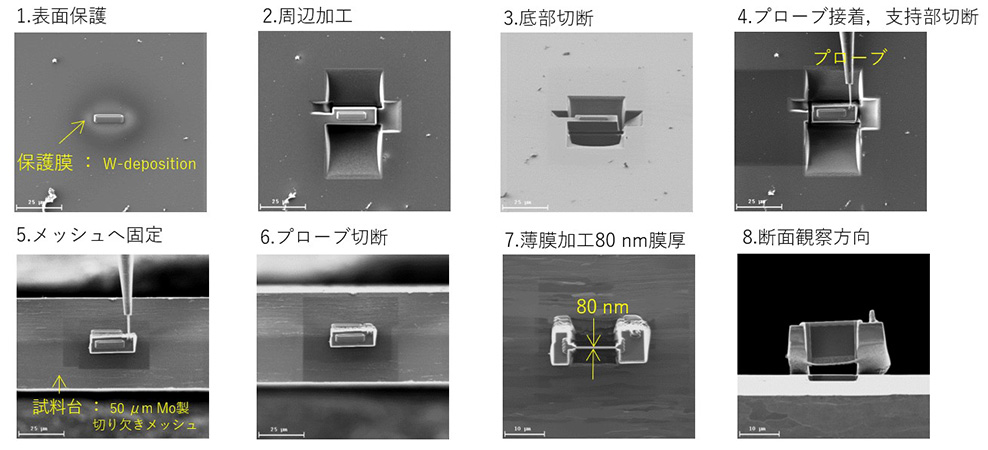
③ 断面加工 (DRAM)
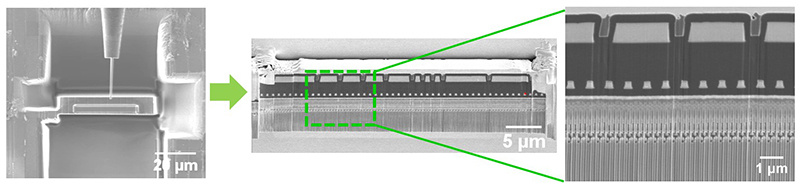
④ TEM観察用薄片加工 (はんだボール)