表面分析
表面形態観察
表面形態観察 概要
「材料の品質問題、表面・界面分析で解決しませんか?」
クリアライズでは、材料の異物、剥離、変色などの原因となる表面・界面の微量な不純物や化学状態を、最先端の分析技術で迅速に特定します。金属、セラミックス、有機材料など幅広い材料に対応。品質向上、歩留まり改善、原因究明に貢献します。まずはお気軽にご相談ください。
オージェ電子分光分析(AES)
表面・粒界の析出・介在物分析、不純物分析
X線光電子分光分析(XPS)
表面の酸化・吸着・汚染状態、表面化合物の化学的結合状態評価
高周波グロー放電発光分光分析(rf-GD-OES)
深さ方向の元素分析、全元素の定性・定量分析/
主な装置・仕様・適用分野
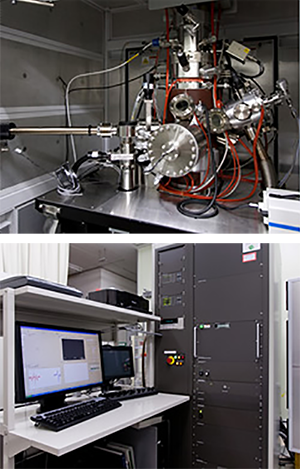
オージェ電子分光分析(AES)
物質の表面・粒界部の析出・介在物分析や不純物の分析に用いられます。
二次電子像を観察しながら、微小領域、極表面の組成分析ができます。
イオン銃を併用することによって、表面から深さ方向の組成の変化をモニタリングできます。
- 仕様
- 電子銃:サーマルフィールドエミッション型
- 最小ビーム径:6nm
- 分析器:CMA
- 走査像:二次電子像
- 分析モード:点分析、線分析、面分析
- 試料冷却破断機構搭載
- 特長
- 検出元素:3Li〜92U
- 極表面分析:1〜2nm(イオン銃の併用によって深さ分析が可能)
- 微小部分析:φ 10nm
- 適用分野
- 金属、セラミックスの微小析出物、介在物の組成、分析
- 金属の酸化膜厚および多層膜の相互、拡散評価
- 金属、セラミックスの粒界破面分析
- 試料
- 〜50mmφ 12mm厚 以下
- 冷却破断用:ノッチ丸棒(定形サイズに加工)
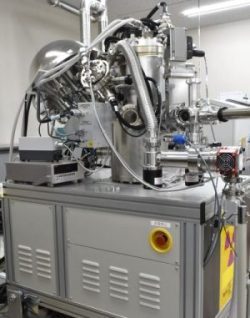
X線光電子分光分析(XPS)
物質の表面の酸化・吸着・汚染状態の解析および表面化合物の結合状態解析に用いられます。
光電子スペクトルやX線励起のオージェスペクトルの波形解析によって、極表面の組成分析や結合状態分析が可能です。
- 仕様
- X線源:Al (モノクロメータ搭載)
- 分析室到達真空:6.7×10-8Pa以下
- 最少ビーム径:10μm以下
- X線スキャン範囲:最大1.4mmφ
- エネルギー分解能:0.5eV以下(Ag 3d5/2)
- 特長
- 検出元素 :3Li〜92U
- 極表面分析:1〜2nm (イオン銃の併用で深さ方向分析可)
- 適用分野
- 金属材料の表面酸化、吸着、汚染状態の評価
- 金属-半導体界面の中間反応層の化学構造解析
- 有機化合物の化学構造解析
- 非晶質材および表面化合物の化学的結合状態評価
- ガラスなどの絶縁物試料の組成分析
- 試料
基本試料サイズ
- 〜35mmφ 7mm 厚以下
- 〜50mmφ 7mm 厚以下
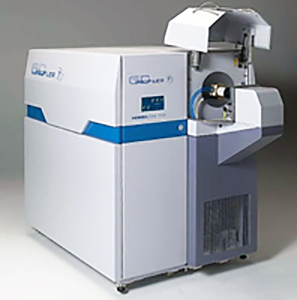
高周波グロー放電発光分光分析(rf-GD-OES)
従来の深さ方向分析装置に比べて測定時間が数分〜数十分と短く、最大分析深さが100µm程度まで可能です。
金属材料だけでなく、非導電性材料(ガラスやセラミックなど)や有機材料など各種材料の測定が可能です。
- 特長
- 検出元素:H 〜 U 最大35元素
- 表面分析:深さ方向 数nm〜100µm程度(材料による)
- 広領域分析:分析領域 φ4 mm、φ2mm
- 適用分野
- 各種材料の成分分析
- 多層膜、めっき、コーティングの組成分析
- 皮膜や薄膜の厚み評価
- 表面変色部の調査
- 電池の電極層の元素分布 etc.
- 試料
基本試料サイズ
- 金属材料:φ10mm〜φ300mm、70mm厚以下
- 有機材料:φ10mm〜φ300mm、 数mm厚以下(材料による)
- 非導電性材料:φ10mm〜300mm、 数mm厚以下(材料による)
分析方法の詳細
帯電中和によるオージェ電子分光分析事例(AES)
1. 概要
AES分析では試料表面に電子線を照射するため、非導電性の試料などは試料表面が負に帯電してしまい、測定が困難となることがあります。
帯電中和機能は、負に帯電した試料表面に低エネルギーのAr⁺イオンを照射することで帯電現象を中和し、測定を可能にするものです。
注1) 試料によっては帯電中和機能を使用しても測定できない場合があります。
2. 分析事例

図1 SEM像とオージェ電子スペクトル 上段:帯電中和あり,下段:帯電中和なし
Zalar回転法を使用した分析事例(AES)
1. 概要
オージェ電子分光法では、イオンスパッタリングとスペクトル測定を繰り返すことにより試料の深さ方向の元素分布を調べることができます(深さ方向分析)。その際、イオンを一定方向から照射すると表面があれてしまい、深さ分解能が低下します。しかし、Zalar回転法を用いて試料を回転させながらスパッタリングすることにより、表面あれが抑制されて深さ分解能の高い結果を得ることができます。
2. 分析事例
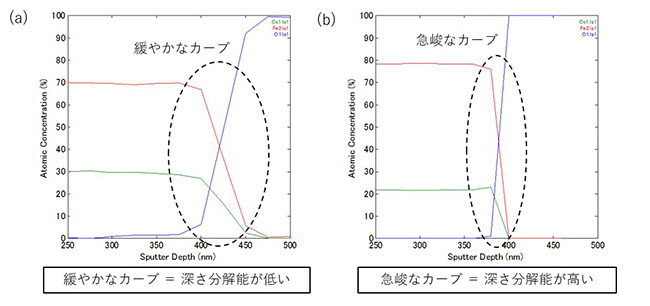
図1 深さ方向分析結果(デプスプロファイル)
(a) Zalar回転なし,(b) Zalar回転あり
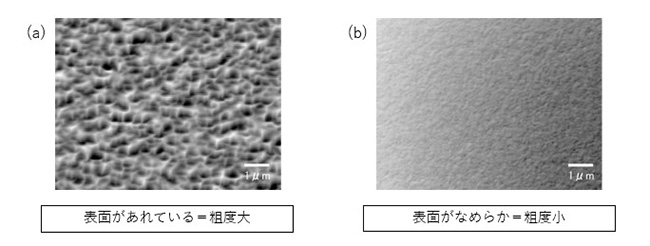
図1 深さ方向分析後の試料表面のSEM像
(a) Zalar回転なし,(b) Zalar回転あり
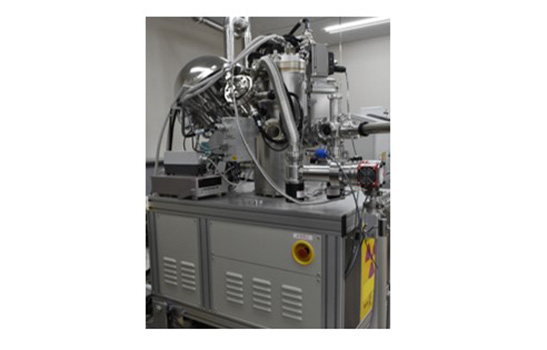
X線光電子分光法 (XPS)
1. 概要
X線光電子分光法 (XPS) は固体材料表面にX線を照射して得られる光電子の運動エネルギーから、材料に含まれる元素の種類とその組成、及び各元素の化学的結合状態などに関する知見を得ることができます。
化学的結合状態に関する知見が得られることから、ESCA (Electron Spectroscopy for Chemical Analysis)とも称されています。
2. 特長
■ 表面の元素・結合状態の非破壊分析
■ 検出元素: 水素・ヘリウム以外の全ての元素
■ 極表面の組成・化学的結合状態評価(≧10nm)
■ 極表面の積層構造解析(≧10nm)
■ Arエッチング併用による深さ方向解析
3. 主な用途
■ 固体表面の状態評価: プロセス後の表面変質や表面付着物評価、膜剥がれなどのプロセス異常、劣化解析
■ 半導体ヘテロ接合のバンド構造解析
■ 自動車の塗装被膜の表面コーティングの構造解析
■ 二次電池の電極材料、例えば電極、セパレータなどの表面状態 (組成・結合状態) 評価、劣化解析
■ 触媒の表面状態 (組成・結合状態) 評価、劣化解析
など
4.装置原理図

5.XPS分析内容決定フローチャート
(1) 存在する元素が不明の場合

(2) 存在する元素が既知もしくは着目元素のみ分析したい場合
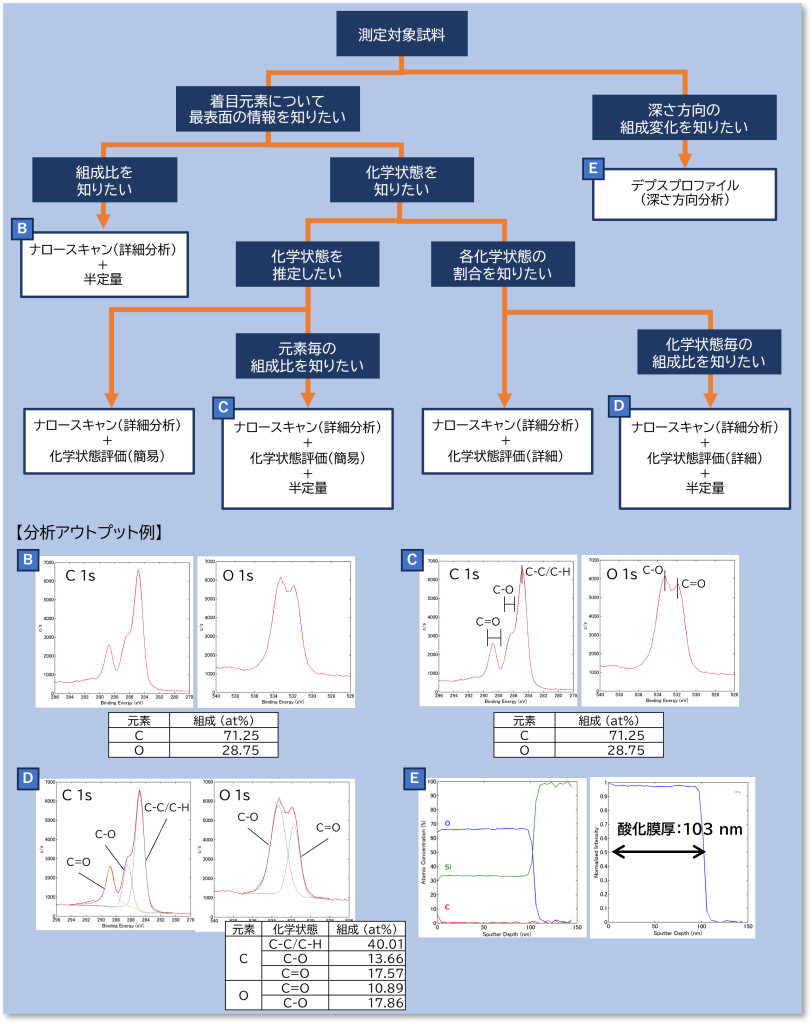
6.分析事例
① MgO (酸化マグネシウム) のバンドギャップ評価
■ 原理
内殻準位から励起された光電子は、束縛エネルギー (Eb) の分だけ (仕事関数を無視すれば) エネルギーを失って放出されます(左上図)。一部の光電子は価電子帯(VBM)を通過する際に、価電子を伝導電子帯に励起し、バンドギャップ (Eg) あるいはそれ以上のエネルギーを失います (右上図)。このため、高Eb側に、信号強度の立ち上がりが生じます。
■ 評価結果
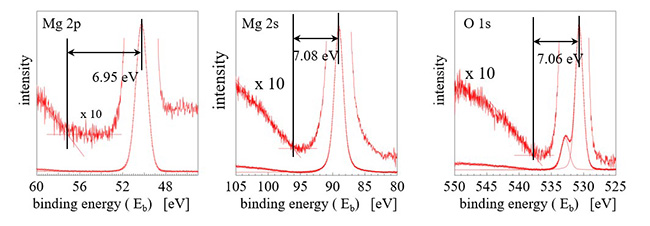
MgOの Eg の評価例を示します。各内殻準位で、Eg = 7 eVの値が得られ、ほぼ一致しています。特に、Mg 2pのスペクトルは高Eb側の平たん部が広く、良好なスペクトルが得られました。
② 半導体へテロ接合のバンド不連続量の評価例
(酸化物透明電極/化合物半導体界面)
■ 評価手順
Inを含んだ化合物半導体表面にZnを含んだ酸化物透明電極のバンド不連続量を評価した一例を示します。評価の手順を以下のフロー図に示します。
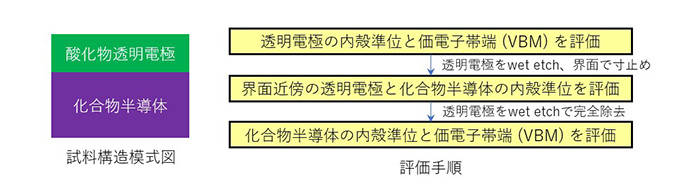
■ 結論
一連の測定より、以下のバンド図が得られました。それぞれのEg (バンドギャップ) が既知であれば、伝導電子帯端 (CBM) の不連続量も得られます。
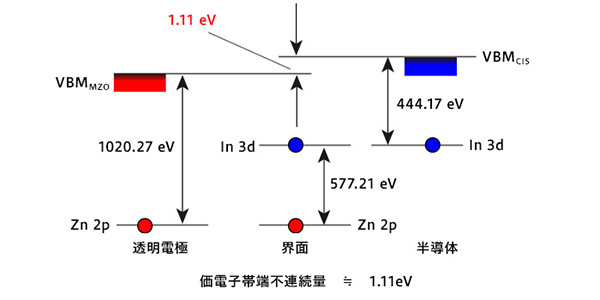
■ 固体表面の状態評価: プロセス後の表面変質や表面付着物評価、膜剥がれなどのプロセス異常、劣化解析
■ 半導体ヘテロ接合のバンド構造解析
■ 自動車の塗装被膜の表面コーティングの構造解析
■ 二次電池の電極材料、例えば電極、セパレータなどの表面状態 (組成・結合状態) 評価、劣化解析
■ 触媒の表面状態 (組成・結合状態) 評価、劣化解析
など
4.装置原理図

5.XPS分析内容決定フローチャート
(1) 存在する元素が不明の場合

(2) 存在する元素が既知もしくは着目元素のみ分析したい場合
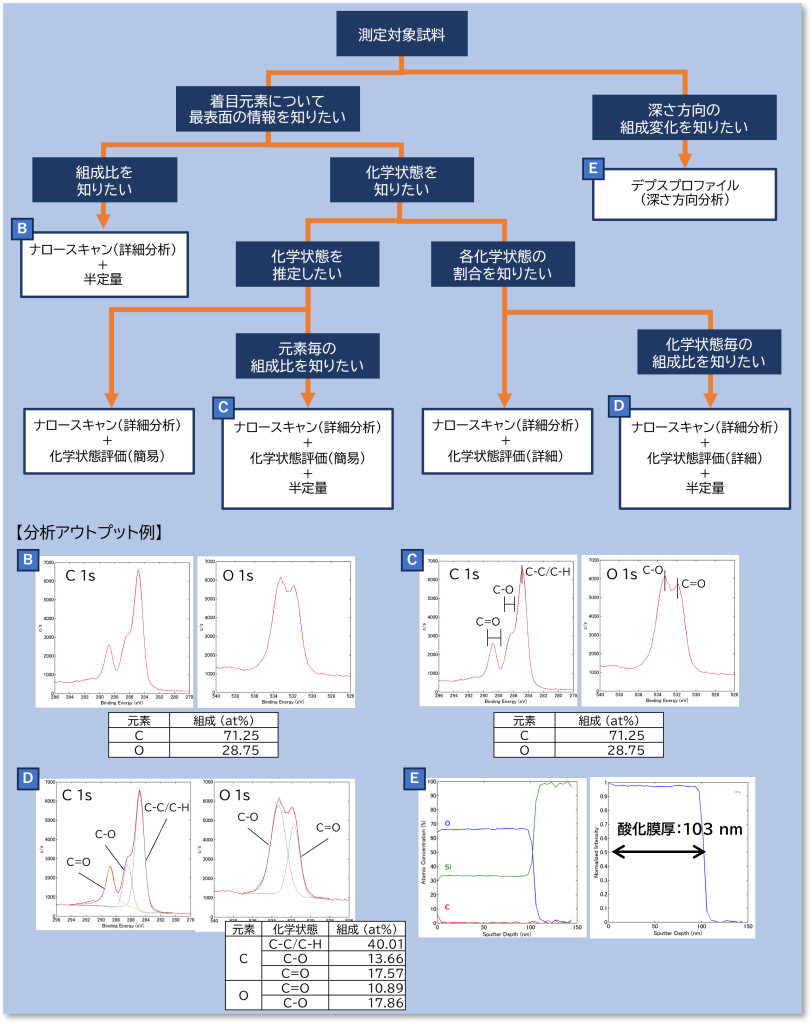
6.分析事例
① MgO (酸化マグネシウム) のバンドギャップ評価
■ 原理
内殻準位から励起された光電子は、束縛エネルギー (Eb) の分だけ (仕事関数を無視すれば) エネルギーを失って放出されます(左上図)。一部の光電子は価電子帯(VBM)を通過する際に、価電子を伝導電子帯に励起し、バンドギャップ (Eg) あるいはそれ以上のエネルギーを失います (右上図)。このため、高Eb側に、信号強度の立ち上がりが生じます。
■ 評価結果
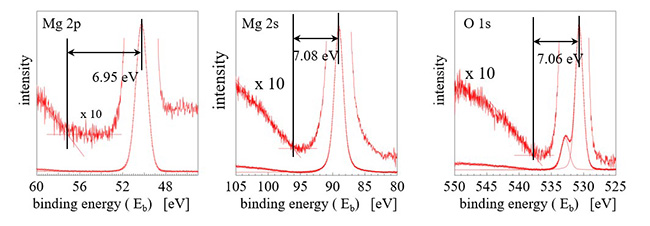
MgOの Eg の評価例を示します。各内殻準位で、Eg = 7 eVの値が得られ、ほぼ一致しています。特に、Mg 2pのスペクトルは高Eb側の平たん部が広く、良好なスペクトルが得られました。
② 半導体へテロ接合のバンド不連続量の評価例
(酸化物透明電極/化合物半導体界面)
■ 評価手順
Inを含んだ化合物半導体表面にZnを含んだ酸化物透明電極のバンド不連続量を評価した一例を示します。評価の手順を以下のフロー図に示します。
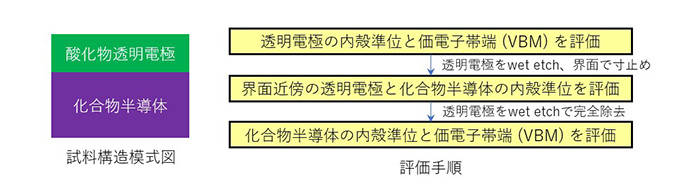
■ 結論
一連の測定より、以下のバンド図が得られました。それぞれのEg (バンドギャップ) が既知であれば、伝導電子帯端 (CBM) の不連続量も得られます。